

Journal of South China University of Technology(Natural Science) >
Thermal Fatigue Simulation and Reliability Analysis of High Density CCGA
Received date: 2022-05-31
Online published: 2022-10-09
Supported by
the Key Research and Development Project of Guangdong Provincial Science and Technology Department(2020B0404030005)
With the characteristics of excellent electrothermal performance and high-density signal interconnection, ceramic column grid array (CCGA) packaging is the first choice in highly reliable applications such as aerospace.When the pin exceeds 1 000, due to the packaging form and the characteristics of the material itself, high-density CCGA is more likely to fail in the environment of temperature change.The paper carried out temperature cycling test for CCGA1144 structure, and studied the stress distribution, variation law, failure cause and mode of welding column through microstructure observation and finite element simulation under the temperature cycling condition of -55~125 ℃. The results show that the variation range of total deformation, equivalent stress, equivalent elastic strain and plastic strain of outer ring welding column is larger than that of inner ring welding column in the process of temperature cycle, and it is more prone to failure, especially the edge welding column of outer ring. The paper identified the weakness of welding column in the thermal fatigue test and pointed out that the two sections of 0.15~0.60 mm and 2.17~2.43 mm are the dangerous areas of crack and fracture failure, and the latter section is more prone to crack and fracture. It put forward three failure modes of thermal fatigue of welding column, and pointed out that the welding column was damaged under the joint action of fatigue mechanism and creep mechanism. Suggestions on the direction of reinforcement and optimization design were given.The research results have guiding significance and reference value for the quality improvement, development and application of high-density CCGA.
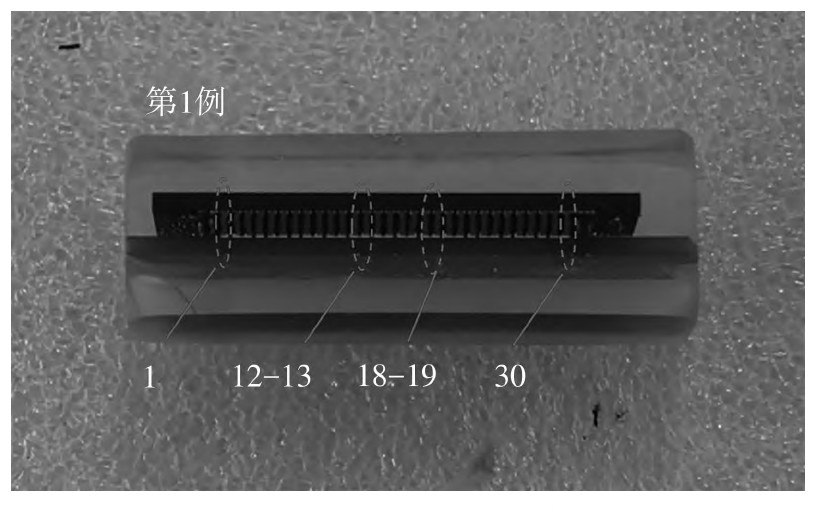
Key words: CCGA; thermal fatigue; finite element; temperature cycle; failure
WANG Xiaoqiang, LI Bin, DENG Chuanjin, et al . Thermal Fatigue Simulation and Reliability Analysis of High Density CCGA[J]. Journal of South China University of Technology(Natural Science), 2023 , 51(3) : 98 -109 . DOI: 10.12141/j.issn.1000-565X.220324
| 1 | RAMESHAM R .Thermal cycling testing to failure of a ceramic column grid array package for space applications[C]∥2017 Pan Pacific Microelectronics Symposium (Pan Pacific).Kauai,HI:IEEE,2017:1-10. |
| 2 | 王惠,官岩,陈灏 .CCGA封装焊点热疲劳寿命分析[J].质量与可靠性,2020(2):31-33. |
| WANG Hui, GUAN Yan, CHEN Hao .A thermal fatigue life prediction study for CCGA solder joints[J].Quality and Reliability,2020(2):31-33. | |
| 3 | 贾柔柔 .倒装焊器件封装关键结构的疲劳寿命预测及可靠性评价[D].北京:北京工业大学,2020. |
| 4 | 李依依 .基于CCGA的系统级封装特性分析与优化[D].西安:西安电子科技大学,2021. |
| 5 | 陈莹磊,王春青,曾超 .基于统计的高密度CCGA封装热循环寿命预测方程[J].电子工艺技术,2010,31(4):196-199. |
| CHEN Ying-lei, WANG Chun-qing, ZENG Chao .Fatigue life prediction equation for high density ceramic column grid array based on statistics[J].Electronics Process Technology,2010,31(4):196-199. | |
| 6 | FLEISHER J, WILLING W .Study of column grid array components for space systems[C]∥2012 Proceedings Annual Reliability and Maintainability Symposium.Reno,NV:IEEE,2012:1-6. |
| 7 | HART M .CCGA solder column-reliable solution for absorbing large CTE mismatch[C]∥Proceedings of the 2015 European Microelectronics Packaging Conference (EMPC).Friedrichshafen:IEEE,2015:1-5. |
| 8 | 李守委,毛冲冲,严丹丹 .CCGA用焊柱发展现状及面临的挑战[J].电子与封装,2016,16(10):6-10. |
| LI Shou-wei, MAO Chong-chong, YAN Dan-dan .Status-quo and challenges of CCGA solder columns[J].Electronics and Packaging,2016,16(10):6-10. | |
| 9 | 姚昕,明雪飞,吉勇,等 .超大规模CCGA器件铜带缠绕型焊柱可靠性研究[J].电子产品可靠性与环境试验,2021,39(S1):51-55. |
| YAO Xin, MING Xue-fei, JI Yong,et al .Research on reliability of copper strip wound solder column for ultra large-scale CCGA devices[J].Electronic Product Reliability and Environmental Testing,2021,39(S1):51-55. | |
| 10 | TRIPATHI S, PATEL H M, PATIL S A,et al .Ceramic column grid array assembly qualification and reliability analysis for space missions[J].IEEE Transactions on Components,Packaging and Manufacturing Technology,2015,5(2):279-286. |
| 11 | TONG L, JIANG C, AO G .Research on the board level reliability of high density CBGA and CCGA under thermal cycling[C]∥Proceedings of the 2018 19th International Conference on Electronic Packaging Technology (ICEPT).Shanghai:IEEE,2018:1382-1386. |
| 12 | GHAFFARIAN R .Reliability of column/board/CCGA attachment[C]∥Proceedings of the 13th Intersociety Conference on Thermal and Thermomechanical Phenomena in Electronic Systems.San Diego,CA:IEEE,2012:619-627. |
| 13 | 南旭惊,刘晓艳,陈雷达,等 .温度循环对CCGA焊柱可靠性影响[J].焊接学报,2021,42(2):81-85. |
| Xu-jing NAN, LIU Xiao-yan, CHEN Lei-da,et al .Effect of thermal cycling on reliability of solder joints of ceramic column grid array package[J].Transactions of the China Welding Institution,2021,42(2):81-85. | |
| 14 | ZHANG L, ZHANG H, ZHANG H,et al .Assembly reliability and failure mechanism analysis of CCGA devices[C]∥Proceedings of the 2022 IEEE 2nd International Conference on Power,Electronics and Computer Applications (ICPECA).Shenyang:IEEE,2022:1105-1108. |
| 15 | ZHU Y, LIU H, CHANG S .Research on the board-level reliability of ceramic column grid array packaging component[C]∥Proceedings of the 2020 21st International Conference on Electronic Packaging Technology (ICEPT).Guangzhou:IEEE,2020:1-4. |
| 16 | Lü X, HUANG Y, LIN P,et al .Reliability study of the solder joints in CCGA package during thermal test[C]∥Proceedings of the 2014 15th International Conference on Electronic Packaging Technology.Chengdu:IEEE,2014:854-857. |
| 17 | ZHANG L, HAN J, HE C,et al .Reliability behavior of lead-free solder joints in electronic components[J].Journal of Materials Science:Materials in Electronics,2013,24(1):172-190. |
| 18 | 吕晓瑞,林鹏荣,王勇,等 .铜带缠绕型焊柱装联结构的板级热-机械可靠性研究[J].电子与封装,2021,21(3):28-35. |
| Xiao-rui Lü, LIN Peng-rong, WANG Yong,et al .Research on the board-level thermo-mechanical reliability of copper tape wound solder column planting device[J].Electronics and Packaging,2021,21(3):28-35. | |
| 19 | DING Y, TIAN R, WANG X,et al .Coupling effects of mechanical vibrations and thermal cycling on reliability of CCGA solder joints[J].Microelectronics Reliability,2015,55(11):2396-2402. |
| 20 | LIU J, SALMELA O, S?RKK? J,等,微电子技术的可靠性 :互连、器件及系统[M].郭福,马立民,译.北京:科学出版社,2013:88-90. |
| 21 | CHEN X, CHEN G, SAKANE M .Prediction of stress-strain relationship with an improved Anand constitutive model for lead-free solder Sn-3.5Ag[J].IEEE Transactions on Components & Packaging Technologies,2005,28(1):111-116. |
| 22 | WILDE J, CHENG Z, WANG G .Influences of packaging materials on the solder joint reliability of chip scale package assemblies[C]∥International Symposium on Advanced Packaging Materials Processes, Properties and Interfaces. Braselton,GA:[s.n.],1999:144-149. |
| 23 | CHE F X, PANG J H L .Thermal fatigue reliability analysis for PBGA with Sn-3.8 Ag-0.7 Cu solder joints[C]∥Proceedings of the Electronics Packaging Technology Conference.Singapore:[s.n.],2004:787-792. |
/
| 〈 |
|
〉 |